XILINX 7系列FPGA封装之芯片常见封装技术详解
🏡《Xilinx FPGA开发指南》
目录
- 1,概述
- 2,常用封装技术
- 2.1,Wire-bond chip-scale
- 2.2,Wire-bond fine-pitch
- 2.3,Flip-chip lidless
- 2.4,Ruggedized flip-chip
- 2.5, Flip-chip fine-pitch
- 2.6,Ruggedized flip-chip fine-pitch
- 2.7,SSI flip-chip fine-pitch
- 2.8,SSI flip-chip fine-pitch (overhang)
- 3,总结
1,概述
FPGA的技术手册中列出了其使用的芯片封装技术,了解这些技术可帮助设计师更精准的选型,但由于对相关技术的描述资料较少,这些专业术语,往往称为部分设计师阅读技术手册的拦路虎。本文将详细解析XILINX 7系列FPGA封装技术,以帮助读者更好的理解学习和选型。

2,常用封装技术
2.1,Wire-bond chip-scale
Wire-bond指引线接合,是使用金线将芯片的晶圆和芯片的封装管脚的焊盘连接在一起的封装技术。金线在热或超声波等的外力作用下与晶圆端紧密结合在一起。实现将芯片的晶圆的管脚连接到封装管脚。
Wire-bond chip-scale是一种芯片级别的引线键合技术,引线直接从chip键合到芯片管脚金属上,是芯片封装最常用的封装技术之一。
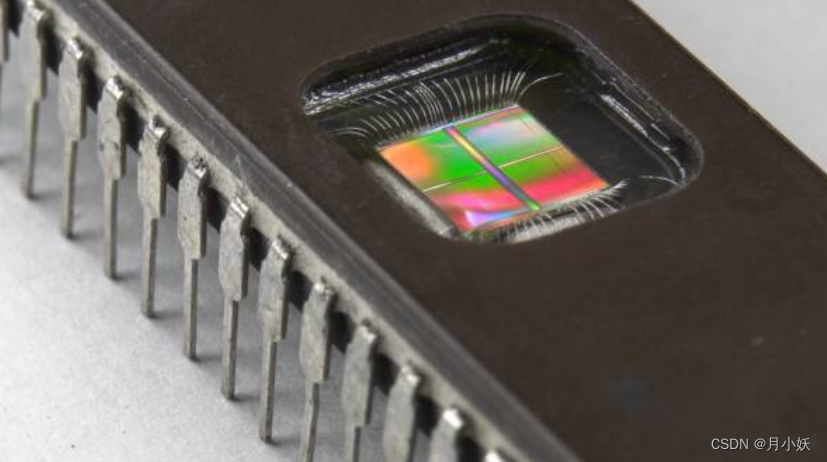
2.2,Wire-bond fine-pitch
Wire-bond fine-pitch叫细间距键合,其基本技术和芯片级键合类似,只是对键合线的间距更密集。
2.3,Flip-chip lidless
Flip-chip是一种倒装焊接的技术。普通的引线键合是指,将芯片晶圆放到封装基板上,然后用金线将晶圆上的PAD和封装管脚相连。而倒装焊接是直接将晶圆倒过来面对面放到封装基板上,直接将晶圆PAD和芯片封装焊接到一起。
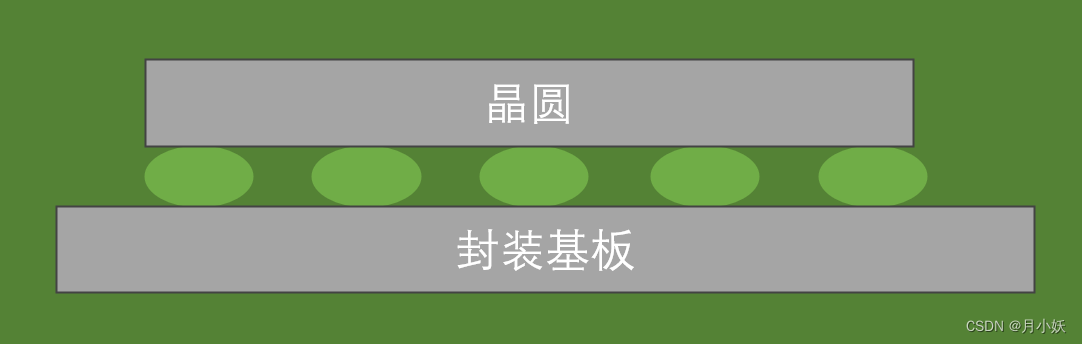
Flip-chip lidless 是指无盖倒装焊接封装,晶圆上面没有上盖板。直接将晶圆封在芯片外壳里面。

2.4,Ruggedized flip-chip
Ruggedized flip-chip 是指加固型倒装焊接封装,晶圆上面有1个加固的盖板,可以有效保护晶圆不被压迫,是除了芯片外壳的二重保护。
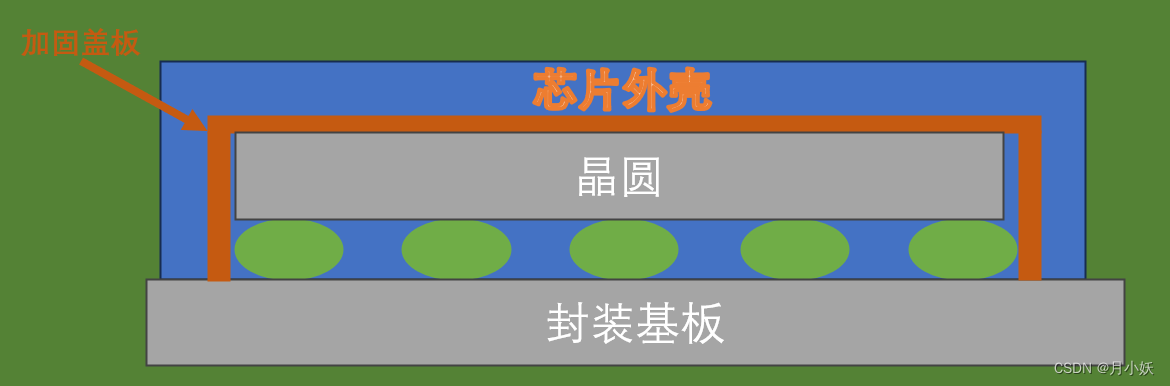
2.5, Flip-chip fine-pitch
Flip-chip fine-pitch指倒装焊接封装技术和细间距键合技术均有应用的一种封装技术。
2.6,Ruggedized flip-chip fine-pitch
Ruggedized flip-chip fine-pitch指加固型倒装焊接封装技术和细间距键合技术均有应用的一种封装技术。
2.7,SSI flip-chip fine-pitch
SSI 是指堆叠硅片互联,与普通的芯片封装技术相比,其有多层基板和晶圆。
SSI flip-chip fine-pitch 是指堆叠硅片互联技术,倒装焊接封装技术和细间距键合技术均有应用的一种芯片封装技术。
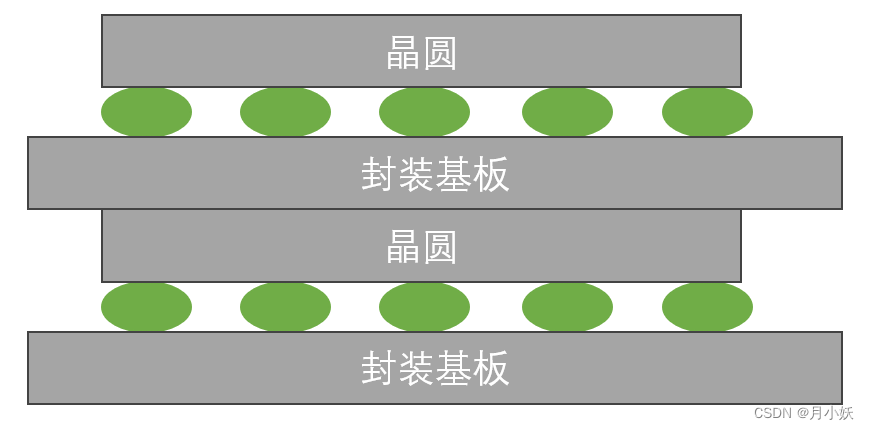
2.8,SSI flip-chip fine-pitch (overhang)
Overhang悬垂键合技术是指在引线键合中使用金线垂直方向键合晶圆和基板。SSI flip-chip fine-pitch (overhang)是指堆叠硅片互联技术,倒装焊接封装技术和细间距键合技术,悬垂键合技术均有应用的一种芯片封装技术
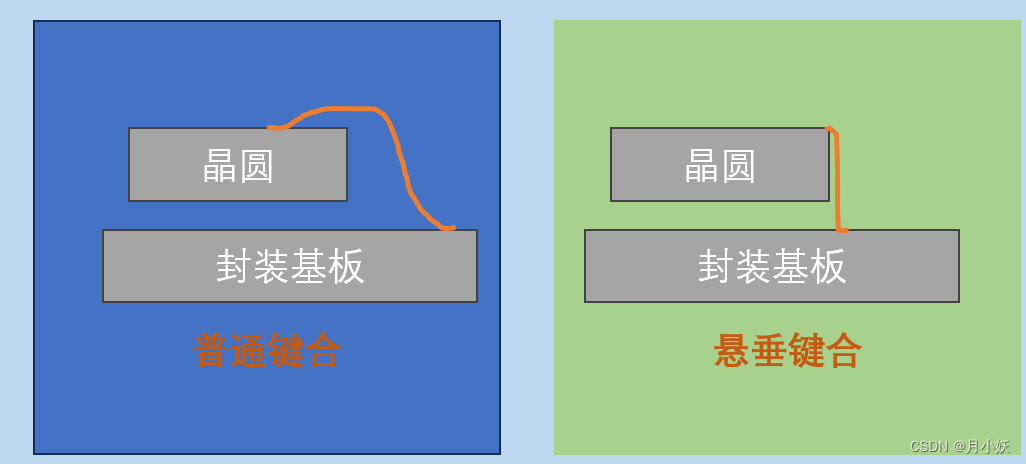
3,总结
高级设计师相对于初中级设计师具备的重要技能就是对细节的把握。了解FPGA的封装技术对于,细分领域更加精准的选型,提升设计师基于FPGA的设计开发能力是非常有用的。
🏡《Xilinx FPGA开发指南》
本文来自互联网用户投稿,文章观点仅代表作者本人,不代表本站立场,不承担相关法律责任。如若转载,请注明出处。 如若内容造成侵权/违法违规/事实不符,请点击【内容举报】进行投诉反馈!